适用范围:
该试验检查芯片长期贮存条件下,高温和时间对器件的影响。本规范适用于量产芯片验证测试阶段的HAST测试需求,仅针对非密封封装(塑料封装),带偏置(bHAST)和不带偏置(uHAST)的测试。简介:
该试验通过温度、湿度、大气压力加速条件,评估非密封封装器件在上电状态下,在高温、高压、潮湿环境中的可靠性。它采用了严格的温度,湿度,大气压、电压条件,该条件会加速水分渗透到材料内部与金属导体之间的电化学反应。引用文件:
下列文件中的条款通过本规范的引用而成为本规范的条款。凡是注日期的引用文件,其随后所有的修改单(不包括勘误的内容)或修订版均不适用于本规范,然而,鼓励根据本规范达成协议的各方研究是否可使用这些文件的新版本。凡是不注日期的引用文件,其新版本适用于本规范。

1. HAST测试流程
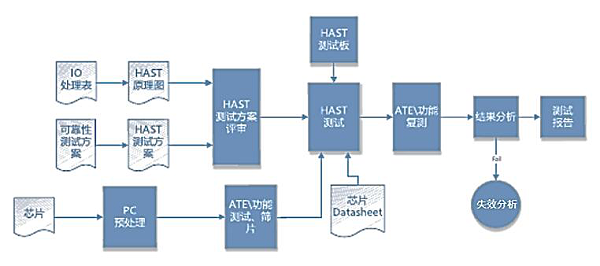
2.1 温度、湿度、气压、测试时间 HAST试验条件如下表所示:

➢ 测试过程中,建议调试阶段监控芯片壳温、功耗数据推算芯片结温,要保证结温不能过 高,并在测试过程中定期记录。结温推算方法参考《HTOL测试技术规范》。
➢ 如果壳温与环温差值或者功耗满足下表三种关系时,特别是当壳温与环温差值超过 10℃时,需考虑周期性的电压拉偏策略。

2.2 电压拉偏
uHAST测试不带电压拉偏,不需要关注该节;
bHAST需要带电压拉偏,遵循以下原则:
(1) 所有电源上电,电压:推荐操作范围电压(Maximum Recommended Operating Conditions)
(2) 芯片功耗小(数字部分不翻转、输入晶振短接、其他降功耗方法);
(3) 输入管脚在输入电压允许范围内拉高。
(4) 其他管脚,如时钟端、复位端、输出管脚在输出范围内随机拉高或者拉低;
2.3 样本量

➢ 高温、高压、湿度控制试验箱(HAST高压加速老化试验箱)——温度、湿度、气压强度范围可控,测试时间可控。
4. 失效判据
➢ ATE功能筛片有功能失效、性能异常。
5. HAST测试注意事项
➢ 测试过程要求每天记录电源电压、电流、环境温度、壳温(推算结温)等关键数据。
➢ 注意芯片内部模拟电路是否有上电默认开启的模块,这样的模块会导致静态电流太大,引起其他机制的失效。
➢ 调试过程注意,考虑到较大的电流引起压降,电压等的记录应该是到板电压,而不是电源源端电压。
➢ 调试过程注意,室温条件下的电源电压与规定要求下的电源电压不同,可以在室温下初调,待试验环境到达HAST设定条件后做终调试。





